靶材是磁控溅射镀膜的原材料,通过带正电的粒子轰击阴极靶材,使靶原子获得能量逸出,从而沉积到基片表面,形成薄膜[1]。经靶材溅射的薄膜被广泛应用于装饰、工模具、节能玻璃、集成电路、半导体、磁记录、平面显示、太阳能电池等领域[2-4]。随着消费市场需求的增大及产业技术的升级,靶材不仅在数量和品种上显著增加,而且对靶材的高利用率和大尺寸化提出了更高的要求。
按照形状大致将靶材分为板状靶材和管状靶材。由于磁控溅射施加的磁场为环形磁场,在溅射时会产生冲蚀现象(图1),导致板状靶材的利用率不到30%,而管状靶材的利用率能达到80%[1,5]。此外,靶材的尺寸越大,可溅射面积越大,镀膜效率越高,因此大尺寸和管状化是靶材生产发展的重要方向。目前,国内缺乏相关技术储备,难以生产一体化且组织均匀的大尺寸及管状靶材[6]。现阶段,生产上使用的靶材均由多块小尺寸拼接而成(图2),拼接靶材因各块微观组织存在差异,导致镀膜性能不一致[7-8]。

等离子喷涂作为一种表面技术,不受尺寸和空间的限制,可在大型工件表面生产出具有一定厚度的涂层,已逐渐应用于靶材生产中。基于等离子喷涂的特点,导致靶材的致密度难以达到95%以上,靶体中存在大量不连续的孔隙,限制了等离子喷涂在靶材生产中的应用。这里将目光聚焦于等离子喷涂近终成形法制备靶材,在介绍靶材的制备方法和技术要求的基础上,结合等离子喷涂的原理和特点,综述了国内外有关等离子喷涂制备靶材的研究现状,并针对等离子喷涂制备靶材的研究进行展望。

1、靶材的制备
1.1靶材的技术要求
按照成分可将靶材分为纯金属靶材、合金靶材和氧化物陶瓷靶材等。虽然成分不同,但对靶材的性能要求趋于一致。性能优异的靶材具有溅射寿命长,所镀膜更均匀、性能更优越等优点。
1.1.1靶材的纯度
靶材的纯度决定着薄膜的光学、电学、力学和耐腐蚀性能。不同行业对靶材纯度的要求不同,玻璃镀膜对纯度要求相对较低[9]。用于纳米互连工艺中的导电薄膜、阻挡层和金属栅,以及先进封装工艺中的重布线层和硅通孔等,均需采用不同种类的高纯金属靶材。在半导体行业中,碱金属元素是危害最大的一类杂质,它在阻挡层中可以自由移动,会影响绝缘效果,通电后释放的高能射线会直接击穿芯片,所以应尽可能控制靶材中杂质的含量,纯度要求达到4N—6N(99.99%~99.9999%)[10]。Glebovsky等[11]制备了高纯钼靶,并研究了其镀膜性能,结果表明,薄膜的导电能力与靶材的纯度呈线性相关,纯度越高,电阻率越小;靶材与薄膜导电性的差异仅取决于溅射条件。
1.1.2靶材的致密度
靶材的致密度影响着磁控溅射沉积速率和镀膜质量。对于致密度较低的靶材,在镀膜时孔隙中的气体会干扰二次电子和其他粒子的飞行路线,被干扰的电子轰击薄膜上的粒子,造成微粒飞溅,会破坏镀膜。
Gehman等[12]使用12组致密度和化学组分不同的靶材,在相同条件下进行溅射镀膜时发现,溅射速率与靶材致密度存在相关性,致密度越高,靶材的溅射效率越高。Lo等[13]制备了致密度分别为82.5%、89.8%、99.5%的钨靶,并测试了其镀膜性能。结果表明,在溅射过程中晶界处的原子优先逸出。致密度较低的靶材(如图3所示)会随着溅射时间的增大,出现晶粒脱落现象,从而污染薄膜。所制备的薄膜呈层状结构,薄膜内部应力较大,随着薄膜厚度的增加,薄膜易发生脱落现象。由此可见,提高靶材的致密度,可显著提高镀膜的效率和质量。

1.1.3靶材的晶粒尺寸及分布均匀性
晶粒尺寸及分布均匀性影响着靶材的溅射速率和镀膜质量。由于晶界处的能量比晶粒内部的能量高,在镀膜时晶界处的原子优先被溅射,因此晶粒尺寸越小,晶界密度越高,溅射速率越高,靶材中晶粒的大小和分布越均匀,得到的薄膜厚度均匀性越好[14]。
Chen等[15]研制了轧制态钼靶和再结晶钼靶溅射薄膜,轧制态钼靶的溅射速率比再结晶钼靶的溅射速率高11%,结果表明,细小、稳定且均匀分布的晶粒结构不仅提高了靶材的溅射速率,同时使得薄膜更致密、性能更一致。
1.1.4靶材的织构
织构影响着靶材的性能和镀膜均匀性。靶材在溅射时,原子优先从最密排方向溅射出来,为了提高溅射速率,需要获得最优织构取向[16]。此外,选择合适的织构取向还可改善溅射靶的磁学性能,提高靶材的利用率[17]。具有先进制程的集成电路芯片对阻挡层的厚度均匀性要求很高,通过控制靶材织构分布的均匀性及优势织构取向的占比可以缩小织构分布梯度,提高镀膜的均匀性[18]。邓超等[19]通过交叉轧制对Ta靶进行加工,研究了变形区形状参数l/h(l为轧辊与试样的接触长度,h为轧制后样品的厚度)对靶材中间层和表面层织构取向的影响。当变形区的形状参数较大时,靶材产生了非常严重的织构梯度,发生了不均匀变形,再结晶异常长大。当变形区形状参数变小时,可以减弱中间层的优势织构,并且使晶粒细化,减弱了Ta靶垂直方向上的织构梯度。通过减弱织构分布的梯度,镀膜的均匀性得到明显提高。
由此可见,靶材的纯度、致密性、晶粒尺寸、晶粒均匀性及织构会对薄膜的沉积效率和性能产生影响,因此靶材质量的好坏常用这些指标来衡量。
1.2靶材的制备方法
1.2.1熔融铸造法
采用熔融铸造法制备靶材的流程如图4所示。采用熔融铸造法制备靶材的优点是杂质含量少、致密度高,还可制备高纯金属靶材[20-22]。缺点:制备难熔金属靶材耗能较高;在制备熔点相差较大的合金靶材时,容易出现成分偏析[23];在制备大尺寸靶材时,轧制加工易导致不同区域的微观组织变化不一致[24];在热处理时,难以控制靶材的晶粒尺寸。刘仁智[25]研究了变形量和热处理温度对钼板的影响,发现变形量大的钼板的晶粒细小,且制备薄膜的晶化程度较好;热处理温度过高,易导致薄膜颗粒粗大,孔隙增加,堆垛严重。吴孟海等[26]对纯度为99.99%的铌锭进行了冷锻、交叉轧制,使其变形率分别达到89%和81%,然后在1100℃下保温1h后真空退火,其平均晶粒尺寸为28.57μm。该研究通过冷变形加工使粗大的晶粒破碎,降低了临界形核能,退火后发生再结晶,减少了缺陷,得到了晶粒尺寸细小且均匀的靶材,但是其工艺流程繁琐,热处理工艺制度难以控制。熔融铸造法适合制备用于半导体和集成电路等行业的超高纯金属靶材,如Ta靶、Ti靶和W靶等。

1.2.2粉末冶金法
采用粉末冶金法制备靶材的流程如图5所示。采用粉末冶金法制备靶材的优点:可制备组分不同的合金靶材;烧结温度远小于材料熔点,耗能低,可制备难熔金属和陶瓷靶材[27-28];制备的靶材晶粒细小且分布均匀。缺点:粉末体积较小,表面能高,容易与氧气发生反应,引入杂质,且难以去除;在烧结过程中,颗粒间逐渐接触,形成烧结颈,之后形成相互独立封闭的孔隙,孔隙不断收缩直至消失,但不会全部消失,致使靶材的致密度偏低。梁俊才等[29]分别采用粉末冶金法和熔融铸造法制备了TiAl合金靶材,并利用磁控溅射工艺镀膜。结果表明,通过粉末冶金法制备的靶材中,元素以单质形式存在,溅射速率更高,镀膜以Ti2AlN相为主;通过熔融铸造法制备的靶材中,合金元素以片层状的TiAl和Ti3Al相出现,溅射速率较低,镀膜以Ti2AlN相和TiN相为主。该研究表明,粉末靶单质相的存在使晶粒更加细小、均匀,镀膜效率和质量优于熔炼靶。张明杰等[30]采用真空电阻烧结法制备了氧化铟锡(IndiumTinOxide,ITO)靶材,研究了烧结阶段温度、升温速率和气氛压力对靶材致密度的影响。结果表明,烧结温度对致密度具有明显影响,当温度达到1550℃时,致密度(99.44%)最大,电阻率为1.829×10−4Ω·cm,此时靶材的电子迁移能力增强;当温度达到1600℃时,致密度为98.30%,电阻率为3.116×10−4Ω·cm。这是由于随着烧结温度的升高,部分铟锡氧化物分解,导致孔隙率增大,电阻率升高。粉末冶金法是目前常见的陶瓷靶材及合金靶材的制备方法。常见的如ITO、Mo-Ti和Mo-Nb靶,已经广泛应用于工业生产中。
1.2.3等离子喷涂法
等离子喷涂的原理如图6所示[31],将喷枪的电极和喷嘴分别接电源负极和正极,通过高频振荡器激发引燃电弧,使供给喷枪的工作气体在电弧的作用下电离成等离子体[32]。在热收缩效应、自磁收缩效应和机械收缩效应的联合作用下,压缩电弧形成了非转移型等离子弧[33]。一般等离子火焰的中心温度可达30000K,粉末喷涂材料进入等离子弧后会被迅速加热至熔融的液滴状态,随着等离子流高速撞击经预处理的基底表面,并不断累积,形成了致密的涂层。
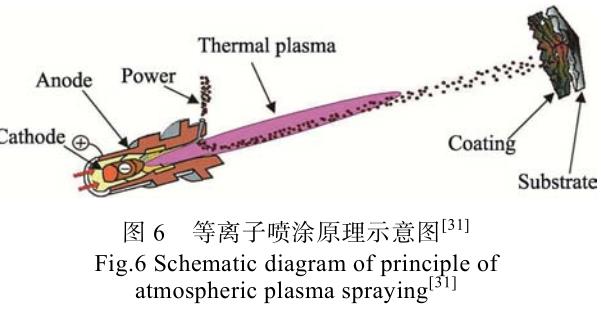
等离子喷涂分为大气等离子喷涂(AtmosphericPlasmaSpraying,APS)、低压等离子喷涂(LowPressurePlasmaSpraying,LPPS)和超低压等离子喷涂(Vary-Low-PressurePlasmaSpraying,VLPPS)。超低压等离子喷涂又称等离子喷涂物理气相沉积(PlasmaSpraying-PhysicalVaporDeposition,PS-PVD)[34]。APS在大气气氛中工作无需真空装置,是最早发展起来的等离子喷涂技术,已经在生产上广泛使用。由于在喷涂过程中原料会与氧气反应,会引入杂质,从而降低纯度,所以不适合制备纯金属靶材。LPPS在惰性气氛或真空环境中进行喷涂,工作压力为4~40kPa,具有低压密闭的工作环境,能保护粉料在喷涂过程中不被氧化。此外,粉料在低压环境中的动能增加,提高了涂层的致密度,其结合强度更好。VLPPS在1kPa下的超低压环境下工作,通过调整喷涂参数,粉末能够以液态、固液共存和气态的方式在基板上沉积,得到不同结构的涂层[34]。通过VLPPS沉积的涂层在基底上以柱状晶的方式生长,厚度可达数十微米[35]。
采用等离子喷涂法制备靶材具有如下特点:等离子射流的超高工作温度可以快速熔化具有高熔点的陶瓷材料和各种难熔合金;不受尺寸的限制,可以生产大尺寸板状和管状靶材[36];工艺步骤简单,喷涂靶材接近最终产品,节约原材料,避免浪费;靶材组织均匀,缺陷较少,性能稳定;通过改变工作环境,避免喷涂过程中发生氧化,减少了杂质的产生,得到了纯度较高的靶材;温度可控,可以熔融具有不同熔点的粉末,易于制备合金靶材;废靶材可通过喷涂修复进行再利用,在溅射过的残靶上进行表面处理,再进行喷涂,修复靶材,达到重复使用的目的,提高了产品的利用率。
采用等离子喷涂法制备的靶材存在孔隙率高、致密度低和组织不连续等问题。如图7所示,涂层内部存在大量孔洞,大致分为3类:颗粒之间未完全结合的层状孔隙;高温熔滴在飞行过程中吸收气体冷却后的球状孔洞;在冷却过程中,由应力所致的竖直方向上的微裂纹[31]。在喷涂过程中,熔融状态的粉料液滴撞击基底,最理想的状态是熔滴迅速铺展,呈圆形,在实际过程中熔滴基于自身的状态、大小和速度等因素,导致它在基底上发生溅射反弹,呈散射状,沉积效率降低,孔隙率增加[37]。另一方面,熔化的粉料在到达基底之前可能发生部分凝固,呈半熔融状态,或完全凝固(呈固态),在基板上不能完全铺展,导致孔隙率升高[38]。此外,熔滴在撞击基底后几毫秒内就会发生凝固,后续熔滴未完全润湿并覆盖已铺展凝固的颗粒,导致颗粒之间存在一定缝隙,使得涂层的平均结合率仅能达到1/3[39]。由此可见,解决等离子喷涂的孔隙率等问题的关键在于研究颗粒状态和界面结合等,需通过合理控制工艺参数,调整粉末的粒径、速度和熔融状态,以及基底的温度、材质和粗糙度,达到改善涂层的微观组织、提高致密度、降低孔隙率的目的[40]。Yao等[41]通过调整沉积温度(即在熔滴撞击前,基底表面包括已经凝固颗粒的表面温度)可以有效地提高涂层的颗粒结合率。临界沉积温度随着材料的熔点呈线性增加趋势,当沉积温度超过临界温度时,颗粒之间的平均结合率大幅提高。随着现代电子工业的发展,等离子喷涂在靶材制造方面显示出巨大潜力,得到了越来越多国内外学者的关注。
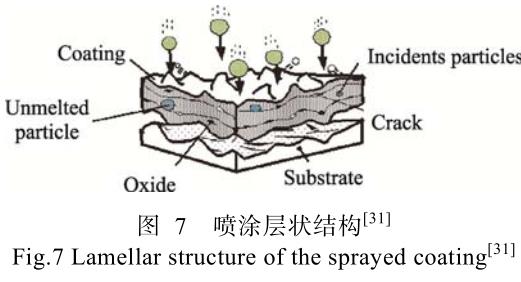
2、等离子喷涂制备靶材
2.1等离子喷涂制备难熔金属靶材
2.1.1钽靶
Ta是一类难熔金属,具有高导电性和高热稳定性等特点,可用于集成电路和半导体等领域[42]。制备Ta靶的主要方法为电子束熔炼和电弧熔炼等,这些方法可以制备出纯度较高、成分均匀和致密度较高的靶材,同时也存在晶粒粗大、尺寸分布不均匀、易产生带状织构、耗能高等问题[24]。Locker等[43]以低压等离子喷涂的方式成功制备了面积为15cm2、厚度为0.5mm的Ta-Hf板状合金靶材。原慷等[44]采用低压等离子喷涂技术制备了钽靶,并探究了原料粉末的球化工艺、喷涂原料粒径和基底预热温度对靶材的影响,在合适的工艺参数下得到了厚度为2mm、纯度为99.999%、氧的质量分数为0.0095%、致密度为99.5%的Ta靶。
2.1.2钼靶
钼具有热膨胀系数高、导电导热性能优异、耐腐蚀性好等特点,并且钼薄膜的比阻抗和膜应力较低[45]。
纯钼及钼合金靶材通过磁控溅射的方式得到的薄膜通常用于显示屏、触摸屏和太阳能电池板等领域。目前,板状钼靶的主要生产方法为粉末冶金法,所制备靶材的晶粒细小均匀,同时存在纯度和致密度不高等缺陷。在制备管状钼靶的工艺路线中,需要用到价格高昂的挤压设备,且绑定工序的难度随着靶材长度的增加而骤增。采用等离子喷涂方法制作大尺寸板状和管状钼靶具有显著优势。王跃明等[46]通过低压等离子喷涂法制备了尺寸为300mm×90mm×3.5mm的板状钼靶和ϕ100mm×200mm×10mm的管状钼靶,并将其与通过大气等离子喷涂法制备的钼靶进行了对比。如图8所示,采用LPPS所制钼靶为定向凝固柱状晶结构,其组织中存在大量粒子层片界面,氧的质量分数、孔隙率分别为0.18%、1.1%,平均显微硬度为361.8HV,抗拉强度达到373.2MPa。采用APS制备的靶材的各项指标均弱于LPPS,其氧含量、孔隙率分别为2.39%、9.5%。说明采用等离子喷涂法制备纯金属靶材在制备过程中对环境气氛较敏感,需要严格控制喷涂室的氧气含量或保持高真空状态,避免氧气和其他杂质对靶材的污染。通过LPPS制备的钼靶可以得到平整、致密且均匀的钼薄膜。
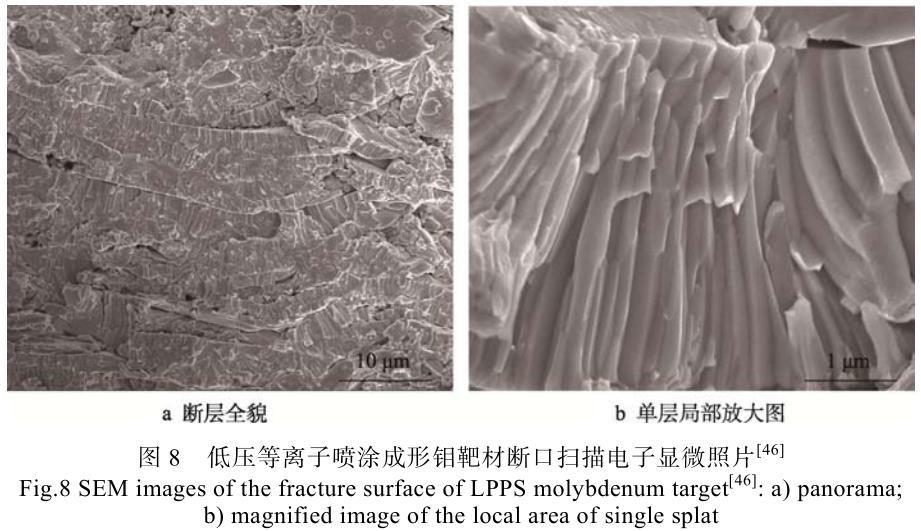
2.1.3钨靶
钨具有熔点高、抗电子迁移性好和热稳定性好等优点,常用于半导体和平面显示等行业[47]。随着该行业的发展,板状靶材难以满足大尺寸镀膜的要求,且利用率不高。通过粉末冶金法制备管状钨靶的难度较高,采用等离子喷涂技术制备大尺寸工件具有显著优势,因此Wang等[48]通过低压等离子喷涂制备了板状和管状钨靶,并研究了真空室压力对钨靶质量的影响。钨靶的微观结构为定向凝固柱状晶层片结构。当真空室的压力为13kPa时,等离子射流的能量密度较低,无法完全熔化原料,靶材存在部分未完全熔化的颗粒,相对密度为93.4%;当压力增至39kPa时,钨粉完全熔化,靶材中仅有极少的未熔融颗粒,相对密度为97.2%,氧的质量分数为0.18%,晶粒的平均尺寸为1μm;当压力增至65kPa时,靶材的氧化程度增加,表面有片状WO3生成,靶材的相对密度降至92.6%,其他指标也不同程度地下降。由此可见,当真空室压力为39kPa时,靶材的性能优良,可以得到致密、平整和光滑的薄膜。
2.2等离子喷涂制备合金靶材
硅属于半导体材料,具有独特的光学和物理特性,广泛应用于触摸屏、显示器、低辐射(Low-Emissivity,Low-E)玻璃和汽车镀膜等领域。然而,硅系薄膜的硬度较低,需要与金属材料复合,以提高薄膜的耐磨性。刚爽等[49]用大气等离子喷涂制备了硅铝管状靶材,研究了粉末粒径对靶材致密度的影响。
结果表明,在粉末粒径较小时,熔化更充分,动能更大,可以得到致密的涂层,但是热应力也随之增加,涂层容易开裂;在粉末粒径较大时,熔化不充分,沉积速度降低,涂层孔隙率较高,但热应力可以充分释放。通过调整粉末的粒径,将靶材的致密度由90%提高至93%左右,检测靶材未出现裂纹,电阻率为9mΩ·cm,镀膜质量和效率均有所提高。陈钦忠等[50]通过等离子喷涂制备了硅镁管状靶材,该靶材的纯度为99.99%,相对密度为95%,电阻率为0.05Ω·cm,与硅铝管状靶材相比,其溅射速率提高了20%。石煜等[51]通过低压等离子喷涂制备了硅铬管状靶材,并采用激光熔覆处理,进一步改善了靶材的性能。由于硅、铬粉末的密度相差较大,导致在喷涂过程中出现了不同密度水平的微粒束,使得靶材组织不均匀、孔隙率增高。在原料处理阶段,通过对硅、铬粉末混合造粒,并在制备造粒浆料时使用超声辅助均质,有效解决了因硅、铬粉末密度相差较大引起靶材组织不均匀的问题。在喷涂后增加激光熔覆处理步骤,使靶材的致密度从94.7%升至98.1%,氧含量从0.88%降至0.19%,效果显著。
2.3等离子喷涂制备陶瓷靶材
2.3.1氧化物陶瓷靶材
二氧化钛是一类具有半导体性质的材料,具有高禁带宽度、高折射率和高催化活性等特点,对紫外线具有较强的阻隔作用,被广泛用作隔热节能材料和光催化材料等[52]。通过钛靶在氧气中反应磁控溅射制备二氧化钛薄膜的效率较低,反应的稳定性难以控制。Tachibana等[53]以等离子喷涂制备的TiO2–x靶材为溅射源,通过直流磁控溅射进行镀膜,其溅射效率较Ti靶在氧气中反应溅射提高了约8倍,TiO2薄膜的性能与通过反应溅射得到的薄膜一致。该研究说明以等离子喷涂制备半导体氧化物靶材,相较于传统的粉末冶金方式,其生产效率更高,生产成本更低,对工业生产具有重要意义。
氧化铌具有高禁带宽度、高折射率、耐腐蚀性等特点,可以作为介质薄膜材料,并应用于low-E玻璃、平板显示、太阳能电池等领域。陈佳[54]通过低压等离子喷涂制备了管状氧化铌靶材,并探究了喷涂参数对靶材质量的影响。在喷涂距离为90mm时,靶材表面出现了许多未熔化的颗粒,表明粉末加热时间较短,且未完全熔化;在喷涂距离为100mm时,原料完全熔化,熔融液滴铺展性较好,提高了涂层的致密度;在喷涂距离为110mm时,靶材的致密度下降。
这是由于颗粒的飞行时间过长,部分粉末重新凝固,铺展能力和结合能力变差,因此最佳喷涂距离为100mm。采用优化后的喷涂参数,得到的靶材尺寸为ϕ229mm×1773mm×12mm,致密度大于95%,纯度为99.95%。该研究成功制备出大尺寸的Nb2O5管状靶材,符合靶材的技术要求,可应用于大型玻璃镀膜。Tului等[55]通过大气等离子喷涂和低压等离子喷涂制备了2组氧化锌陶瓷靶材,并研究了喷涂工艺对靶材质量的影响。通过实验发现,LPPS的喷涂速率明显高于APS的喷涂速率,薄膜的电阻率更低。LPPS靶材出现了部分金属锌,说明在温度超过1400K时,部分ZnO被气流中的H2还原,或发生了高温热分解。对于LPPS制备的氧化锌靶材溅射镀膜,发现薄膜中含有质量分数为25%的ZnO1–x,未发现单质锌。钙铝石电子化合物是一类透明的导电化合物,其化学稳定性较好,在450℃下可稳定存在,具有较低的逸出功、较好的耐离子轰击能力和可控的电性能,可应用于电子器件、催化剂和超导等领域[56]。七铝酸十二钙陶瓷靶材存在制备周期长、流程繁琐等缺点,制约了它在磁控溅射领域的应用。杨永添等[57]通过APS方式制备了12CaO·7Al2O3陶瓷管状靶材,并测试了不同的钙化合物和铝化合物原料对靶材性能的影响。当原料为碳酸钙和α-氧化铝时,靶材的性能优良;在喷涂过程中加入体积分数为0.5%~2.6%的氢气对粉体进行轻度还原,提高了靶材的导电性;在靶材背管中通入80℃的热水,控制温度梯度,防止涂层开裂,制作出尺寸为ϕ1220mm×88mm×3mm的靶材,其表面光滑平整、无裂纹,相对密度为95%,电阻率为0.01~0.02Ω·cm,粉体利用率达到70%。氧化锌镁(ZincMagnesiumOxide,ZMO)属于宽带隙半导体材料。ZnO和MgO均为满价化合物,其导电能力较差,可通过掺杂Al2O3控制其禁带宽度和导电性,并应用于紫外光电器件等领域。通过冷等静压烧结可以获得高质量的ZMO靶材,但是存在设备昂贵、工艺复杂、成本较高等缺点,难以实现规模化生产。张玉玲等[58]通过低压等离子喷涂方法制备了ZMO靶材,研究了不同方法制备的靶材在性能上的差异,LPPS靶材的相对密度为92.6%,电阻率为2.7×10−3Ω·cm;APS靶材的相对密度为91.5%,电阻率为6.8×10−3Ω·cm;通过冷等静压烧结(Cold PressingandSintering,CPS)方法制备的靶材的相对密度为90.8%,电阻率为7.2×10−3Ω·cm。由此可见,LPPS靶材的性能显著优于通过冷压烧结法和大气等离子喷涂法制备的靶材。
氧化铝具有高硬度的特点,可以用作手机后壳的保护层。由于氧化铝具有绝缘性,Al2O3靶材只适用于生产效率低的射频磁控溅射,通过反应溅射纯Al靶材时容易出现氧中毒现象,且薄膜的均匀性较差。林志河等[59]在Al2O3粉末中掺杂了少量TiO2粉末,通过等离子喷涂法制备了Al2O3-TiOx靶材,并研究了TiO2掺杂量对靶材导电性的影响。当TiO2掺杂量(质量分数)达到70%时,靶材的表面电阻率为38Ω·cm。当TiO2掺杂量达到50%时,靶材的表面电阻率为10.8Ω·cm。说明TiO2掺杂量越大,靶材的导电性越好。
通过中频磁控溅射制备的Al2O3-TiOx薄膜在保证薄膜硬度的同时,不仅可提高其导电性,还能提高生产效率。
2.3.2其他陶瓷靶材
羟基磷灰石(Hydroxyapatite,HA)是人体骨骼的主要成分,具有绝佳的生物相容性,在医学领域应用广泛。Hung等[60]通过等离子喷涂法制备了直径为50.8mm、厚度为2mm、密度为2.83g/cm3的HA靶材,并与通过热等静压(HotIsostaticPressing,HIP)和CPS制备的靶材进行对比,溅射后靶材的形貌如图9所示。HIP靶材的密度虽然达到了3.1g/cm3,接近于理论密度(3.16g/cm3),但是在50W的溅射功率下,由于HA靶材在热等静压阶段(1100℃左右)会产生残余应力,使得靶材在溅射时出现了裂纹。此外,HA靶材与铜背板的热膨胀系数不匹配,也导致靶材出现了裂纹。CPS靶只能承受70W的溅射功率,但是因其密度相对较低(1.43g/cm3),在溅射时并未出现裂纹。APS靶可以承受300W的溅射功率,溅射速率达到4.62nm/min,远高于CPS靶的0.578nm/min。这是由于喷涂靶材的组织分布均匀,使其在大功率射频溅射下表现更优异。

YBa2Cu3O7-x(YBCO)是一类高温超导材料,在微电子封装、超导电线和磁屏蔽等领域具有重要应用。
管状靶材可以提高生产效率,但是YBCO是一类脆性陶瓷材料,难以通过塑性变形贴合到管状背管上,因此VanDriessche等[61]尝试用超音速火焰喷涂法和大气等离子喷涂法制备YBCO管状靶材,并对比了二者的性能。采用超音速火焰喷涂法制备靶材的孔隙率高达26%,与基底的临界结合力为78N;APS靶材的孔隙率仅为5%,与基底的临界结合力为151N。在靶材中掺杂少量Ag可以提高电导率和导热系数,使溅射速率提高到10nm/min。
2.4喷涂修复靶材
靶材在溅射后会产生环形跑道状的蚀坑(如图10所示),导致靶材的利用率较低[62]。其中,圆形板靶的利用率仅为10%,矩形板靶的利用率为20%,均难以超过30%,而管状靶材的利用率可达到80%。目前,对废靶的回收再利用需要经过复杂的工艺步骤,不仅经济效益低,而且会使用强酸等危险化学药品,对环境的污染较大。直接对靶材进行修复再利用,可以简化工艺流程,提高生产效益,避免浪费,实现绿色制造。王瑜等[63]采用真空烧结法,将镝、铽合金粉末和两性金属粉末填充到待修复靶材的损耗区进行烧结,其中两性金属起到了钎焊作用,提高了修复靶强度,降低了烧结温度。张久兴等[64]采用放电等离子烧结的方法,在石墨模具内将W粉放在待修复的W靶上进行预压后,再进行烧结,得到了修复后的靶材。Huang等[65]利用放电等离子烧结对W-10%Ti靶进行了修复,研究了原始靶和修复靶的中心、边缘的性能,靶材的表面轮廓及形貌如图11所示。结果表明,修复靶的βTi(W)相含量低于原始靶,且再生靶的晶粒尺寸、相对密度和维氏硬度均略高于原靶。这些方法虽然成功修复了靶材,但是仍然存在组织不均匀、修复部分与原始靶界面未完全结合等问题。
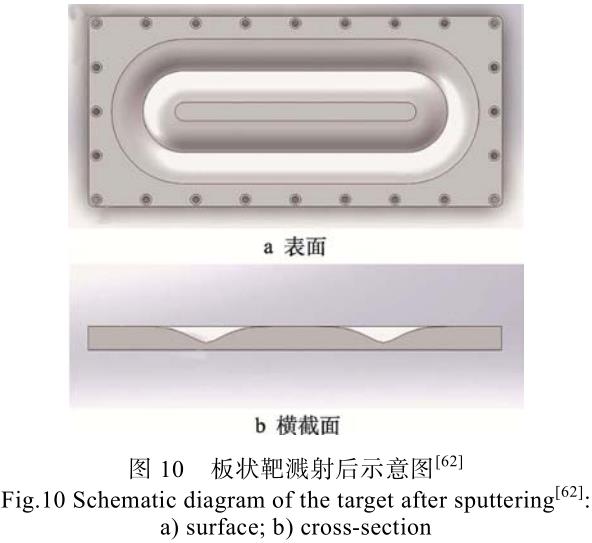
等离子喷涂技术可以为复杂几何形状的工件制备涂层,并且得到的组织较均匀,可以对破损涂层进行二次修复。刘志强[66]研究了等离子喷涂NiAl、NiCrAl涂层的再涂覆性能,对原涂层进行了剥离,并检测了背板元素成分,再对背板进行了二次喷涂,新涂层的致密度和结合强度等与原涂层一致,且外观和成分无明显变化。采用等离子喷涂法制备靶材是材料不断累积的过程,对溅射后的残靶通过等离子喷涂再修复具有技术上的延续性,在对残靶表面进行预处理和合理选择喷涂参数的前提下,可以保证修复靶组织与原靶组织的一致性。林志河等[67]通过等离子喷涂技术对管状铌靶的残靶进行了修复,在修复前削去了溅射造成的凹凸层,并对残靶表面积累的非导电化合物和导电性较差的化合物进行了清洗活化,提高了残靶的表面自由能,增强了新涂层与残废靶的结合力。

采用等离子喷涂法将纯度为99.9%的铌粉进行再加工,可以得到修复完整的管状铌靶材。在硅铝靶材溅射至4mm左右时,其表面会被污染,生成导电性较差的化合物,影响了薄膜的质量,通过残靶修复可以提高靶材的利用率。为了解决新喷涂粉末与残靶的结合力低问题,葛源等[68]在残靶表面进行了激光表面处理,使电阻率较高的化合物熔化,并快速冷却,发生再结晶,在残靶表面生成了球状颗粒,增强了喷涂硅铝粉末的结合力,形成结构趋于一致的硅铝靶材。
3、结语
目前,采用等离子喷涂法可以制备金属靶材和陶瓷靶材等,但是仍处于研究阶段,且制备靶材的性能难以满足生产需求。针对镀膜对靶材性能的要求,等离子喷涂制备靶材在以下方面还有待进一步研究。
1)等离子喷涂气氛对靶材成分和性能的影响,如在惰性气体和稀薄气体中喷涂可以减少靶材的污染,提高靶材的纯度和致密度,这对制备高纯靶材具有重要意义。此外,利用喷涂气氛,使粉体在飞行过程中与气氛发生反应,可得到所需的化合物靶材。由此可见,研究喷涂气氛对涂层成分和性能的影响,可以节省前端原料,也可满足制备不同靶材的需求。
2)等离子喷涂原料对靶材性能具有较大的影响,如原料粒径、分布和形态对涂层致密度的影响。合金粉末密度相差较大,会导致喷涂过程中粉末的飞行状态不一致,使实际成分偏离靶材成分。粉末的粒径分布直接影响靶材的致密化,可以通过大、小颗粒粉末的混合,提高靶材的致密度。原料粉体的形态也会影响靶材的质量,应着力研究粉体的制备方法,改善粉体的表面形态,进一步研究它对涂层性能的影响,提高喷涂靶材的致密度。
3)喷涂参数(如喷枪距离和设备功率等)直接影响靶材的性能。目前,喷涂参数与靶材质量的关系大都局限于简单分析,缺乏系统性的研究。通过优化喷涂参数可以得到质量优异的靶材,如通过调控喷涂参数研究粉末的运动规律、粉末在涂层中的沉积机制、涂层的致密度和结合力等问题,得到靶材涂层的形成机制和质量差异原因,从喷涂沉积涂层的原理方面入手选择喷涂参数。
4)修复靶材是等离子喷涂制备靶材的重要优势,但是相关的工作仍较少。如残靶表面活性化处理,新粉体与残靶的结合力等问题,仍然缺乏全面而深入的研究,下一步需对残靶修复前的处理机制及后期新粉补充工作机制进行更深入的研究。
参考文献:
[1]陈海峰, 薛莹洁. 国内外磁控溅射靶材的研究进展[J].表面技术, 2016, 45(10): 56-63.
CHEN Hai-feng, XUE Ying-jie. Research Progress of Magnetron Sputtering Target at Home and Abroad[J].Surface Technology, 2016, 45(10): 56-63.
[2]迟迅, 宋长虹, 鲍君峰, 等. 磁控溅射制备钛基薄膜研究进展[J]. 热喷涂技术, 2020, 12(2): 17-21.
CHI Xun, SONG Chang-hong, BAO Jun-feng, et al.Research Progress of Titanium-Based Thin Films Pre-pared by Magnetron Sputtering[J]. Thermal Spray Tech-nology, 2020, 12(2): 17-21.
[3]迟伟光, 张凤戈, 王铁军, 等. 溅射靶材的应用及发展前景[J]. 新材料产业, 2010(11): 6-11.
CHI Wei-guang, ZHANG Feng-ge, WANG Tie-jun, et al.Application and Development Prospect of Sputtering Target[J]. Advanced Materials Industry, 2010(11): 6-11.
[4]钟毅, 王达健, 刘荣佩. 铟锡氧化物靶材的应用及管状靶材的爆炸成形[J]. 稀有金属材料与工程, 1997, 26(4):60-63.
ZHONG Yi, WANG Da-jian, LIU Rong-pei. Application of ITO Target and the Explosive Forming Technology of ITO Tubular Target[J]. Rare Metal Materials and Engi-
neering, 1997, 26(4): 60-63.
[5]ISEKI T. Flat Erosion Magnetron Sputtering with a Moving Unbalanced Magnet[J]. Vacuum, 2006, 80(7):662-666.
[6]陈艳芳, 谢敬佩, 王爱琴, 等. 钼及钼合金溅射靶材的研究现状与发展趋势[J]. 粉末冶金技术, 2018, 36(5):393-398.
CHEN Yan-fang, XIE Jing-pei, WANG Ai-qin, et al.Research Status and Development Trend of Molybdenum and Molybdenum Alloy Sputtering Targets[J]. Powder
Metallurgy Technology, 2018, 36(5): 393-398.
[7]崔诣. 浅议 ITO 靶材的制备方法及发展趋势[J]. 有色矿冶, 2013, 29(4): 36-39.
CUI Yi. Discussion on Preparation Method and Develop-ment Trend of ITO Target[J]. Non-Ferrous Mining and Metallurgy, 2013, 29(4): 36-39.
[8]SIMONS C, KASTNER A, KIRIAKIDIS G. Ceramic Target Materials for Sputtering Applications[J]. Materials Science Forum, 2010, 638: 805-811.
[9]何金江, 贺昕, 熊晓东, 等. 集成电路用高纯金属材料及高性能溅射靶材制备研究进展[J]. 新材料产业,2015(9): 47-52.
HE Jin-jiang, HE Xin, XIONG Xiao-dong, et al. Research Progress in Preparation of High Purity Metal Materials and High Performance Sputtering Targets for Integrated Circuits[J]. Advanced Materials Industry, 2015(9): 47-52.
[10]安耿, 李晶, 刘仁智, 等. 钼溅射靶材的应用、制备及发展[J]. 中国钼业, 2011, 35(2): 45-48.
AN Geng, LI Jing, LIU Ren-zhi, et al. The Application,Manufacture and Developing Trend of Molybdenum Sputtering Target[J]. China Molybdenum Industry, 2011,
35(2): 45-48.
[11]GLEBOVSKY V G, MARKARYANS E A. Thin Film Metallization by Magnetron Sputtering from Highly Pure Molybdenum Targets[J]. Journal of Alloys and Com-
pounds, 1993, 190(2): 157-160.
[12]GEHMAN B L, JONSSON S, RUDOLPH T, et al.Influence of Manufacturing Process of Indium Tin Oxide Sputtering Targets on Sputtering Behavior[J]. Thin Solid
Films, 1992, 220(1/2): 333-336.
[13]LO C F, MCDONALD P, DRAPER D, et al. Influence of Tungsten Sputtering Target Density on Physical Vapor Deposition Thin Film Properties[J]. Journal of Electronic Materials, 2005, 34(12): 1468-1473.
[14]DUNLOP J A, POULIQUEN B Y, DRINNON T J, et al.Effects of Aluminum Silicon Copper Sputtering Target Processing Methods on Thin Film Uniformity and Process Control during very Large Scale Integrated Device Fabrication[J]. Journal of Vacuum Science & Technology A: Vacuum, Surfaces, and Films, 1993, 11(4): 1558-1565.
[15]CHEN J K, TSAI B H, HUANG H S. Effects of Moly-bdenum Microstructures on Sputtered Films[J]. Materials Transactions, 2015, 56(5): 665-670.
[16]王晖, 夏明星, 李延超, 等. 难熔金属溅射靶材的应用及制备技术[J]. 中国钨业, 2019, 34(1): 64-69.
WANG Hui, XIA Ming-xing, LI Yan-chao, et al.Application and Preparation Technology of Refractory Metal Sputtering Target[J]. China Tungsten Industry,2019, 34(1): 64-69.
[17]WEIGERT M, SCHITTNY St U, GEHMAN B L.Improved Magnetic Behaviour of Cobalt-Based-Alloy Sputter-Target Material[J]. Materials Science and Engi-neering: A, 1991, 139: 359-363.
[18]钟景明, 何季麟, 汪凯, 等. 芯片用钽阻挡层材料织构控制技术研究[J]. 稀有金属, 2018, 42(12): 1273-1280.
ZHONG Jing-ming, HE Ji-lin, WANG Kai, et al. Texture Control of Tantalum Barrier Layer Used for Chips[J].Chinese Journal of Rare Metals, 2018, 42(12): 1273-1280.
[19]邓超, 刘施峰, 姬静利, 等. 变形区形状参数对钽板组织均匀性的影响[J]. 稀有金属材料与工程, 2014, 43(8):2017-2022.
DENG Chao, LIU Shi-feng, JI Jing-li, et al. Influence of Roll Gap Geometry on Through-Thickness Uniformity of Texture and Microstructure in Clock-Rolled Tantalum[J].Rare Metal Materials and Engineering, 2014, 43(8):2017-2022.
[20]梁静, 林小辉. 等离子喷涂技术在溅射靶材制备中的应用[J]. 中国钼业, 2014, 38(2): 43-46.
LIANG Jing, LIN Xiao-hui. Application of Plasma Spra-ying Technology in Preparation of Sputtering Targets[J].China Molybdenum Industry, 2014, 38(2): 43-46.
[21]邓自南, 刘竞艳. LCD 溅射靶材用大尺寸钼板工艺、组织、织构与性能研究[J]. 中国钼业, 2013, 37(3): 36-42.
DENG Zi-nan, LIU Jing-yan. Research on Technology,Microstructure, Texture and Properties of Large-sizedMolybdenum Plate to Produce Lcd Sputtering Target[J].
China Molybdenum Industry, 2013, 37(3): 36-42.
[22]张冷, 张维佳, 宋登元, 等. 铜铟镓硒薄膜的真空制备工艺及靶材研究现状[J]. 功能材料, 2013, 44(14):1990-1994.
ZHANG Leng, ZHANG Wei-jia, SONG Deng-yuan, et al.State-of-Arts of Vacuum Fabrication Technology of CIGSThin Film and Its Sputtering Target[J]. Journal of Func-tional Materials, 2013, 44(14): 1990-1994.
[23]贾国斌, 冯寅楠, 贾英. 磁控溅射用难熔金属靶材制作、应用与发展[J]. 金属功能材料, 2016, 23(6): 48-52.
JIA Guo-bin, FENG Yin-nan, JIA Ying. Manufacture,Application and Development of Refractorymetal TargetUsed on Magnetron Sputtering[J]. Metallic Functional
Materials, 2016, 23(6): 48-52.
[24]刘宁, 杨辉, 姚力军, 等. 集成电路用大尺寸高纯钽靶材的制备工艺进展[J]. 集成电路应用, 2018, 35(2):24-28.
LIU Ning, YANG Hui, YAO Li-jun, et al. The Progresses on Fabrication of Large Size High-Purity Tantalum Targets for Integrated Circuits[J]. Application of IC, 2018,
35(2): 24-28.
[25]刘仁智. 钼板轧制及热处理工艺对溅射薄膜微观组织及性能的影响[J]. 材料导报, 2014, 28(22): 102-105.
LIU Ren-zhi. Effect of Molybdenum Plate Rolling Process and Heat Treatment on Sputtering Films Microstructure and Property[J]. Materials Review, 2014,
28(22): 102-105.
[26]吴孟海, 聂腾飞, 唐建成, 等. 细晶粒高纯铌靶材的研制[J]. 稀有金属与硬质合金, 2021, 49(4): 62-66.
WU Meng-hai, NIE Teng-fei, TANG Jian-cheng, et al.Development of Niobium Target with Fine Grain and High Purity[J]. Rare Metals and Cemented Carbides,
2021, 49(4): 62-66.
[27]罗俊锋. 粉末冶金靶材的制备与应用[J]. 中国金属通报, 2011(31): 40-41.
LUO Jun-feng. Preparation and Application of Powder Metallurgy Target[J]. China Metal Bulletin, 2011(31):40-41.
[28]许彦亭, 郭俊梅, 王传军, 等. 贵金属溅射靶材的研究进展[J]. 机械工程材料, 2021, 45(8): 8-14.
XU Yan-ting, GUO Jun-mei, WANG Chuan-jun, et al.Research Progress on Precious Metal Sputtering Target[J].Materials for Mechanical Engineering, 2021, 45(8): 8-14.
[29]梁俊才, 周武平, 张凤戈, 等. 溅射靶材对 TiAlN 涂层形貌、结构和力学性能的影响[J]. 真空科学与技术学报, 2014, 34(7): 714-719.
LIANG Jun-cai, ZHOU Wu-ping, ZHANG Feng-ge, et al.Influenceof Target on Microstructures and Mechanical Behavior of TiAlN Coatings[J]. Chinese Journal of
Vacuum Science and Technology, 2014, 34(7): 714-719.
[30]张明杰, 陈敬超, 彭平, 等. 烧结工艺对 ITO 靶材致密度与电阻率的影响[J]. 粉末冶金材料科学与工程,2015, 20(4): 623-630.
ZHANG Ming-jie, CHEN Jing-chao, PENG Ping, et al.Effect of Sintering Process on the Density and Resistivity of ITO Target Materials[J]. Materials Science and Engi-
neering of Powder Metallurgy, 2015, 20(4): 623-630.
[31]TOMA L, KELLER N, BERTRAND G, et al. Elaboration and Characterization of Environmental Properties of TiO2 Plasma Sprayed Coatings[J]. International Journal ofPhotoenergy, 2003, 5(3): 141-151.
[32]邹莉. 等离子喷涂技术及其应用[J]. 昆明冶金高等专科学校学报, 2005, 21(5): 52-55.
ZOU Li. Plasma Spraying Technology and Its Appli-cation[J]. Journal of Kunming Metallurgy College, 2005,21(5): 52-55.
[33]蔡宏图, 江涛, 周勇. 热喷涂技术的研究现状与发展趋势[J]. 装备制造技术, 2014(6): 28-32.
CAI Hong-tu, JIANG Tao, ZHOU Yong. Research Status and Development of the Thermal Spray Technology[J].Equipment Manufacturing Technology, 2014(6): 28-32.
[34]DARUT G, NIEDERHAUSER A, JACCOUD B, et al.VLPPS: An Emerging Process to Create Well-Defined Components by Additive Manufacturing[J]. Journal of
Thermal Spray Technology, 2019, 28(1): 255-264.
[35]李长久. 热喷涂技术应用及研究进展与挑战[J]. 热喷涂技术, 2018, 10(4): 1-22.
LI Chang-jiu. Applications, Research Progresses and Future Challenges of Thermal Spray Technology[J]. Ther-mal Spray Technology, 2018, 10(4): 1-22.
[36]迟伟光. 一种以喷雾干燥工艺制备 AZO 粉末及平面和旋转靶材的方法: 中国, 102134702A[P]. 2011-07-27.
CHI Wei-guang. Method for Preparing AZO Powder and Flat and Rotary Targets by Spray Drying Process: China,102134702A[P]. 2011-07-27.
[37]王海斗, 陈书赢, 马国政, 等. 等离子射流与喷涂粒子微观交互作用研究现状[J]. 机械工程学报, 2017,53(24): 1-11.
WANG Hai-dou, CHEN Shu-ying, MA Guo-zheng, et al.Research on the Micro Interaction of Plasma Jet and Spraying Particles: A Review[J]. Journal of Mechanical
Engineering, 2017, 53(24): 1-11.
[38]LI Chang-jiu, YANG Guan-jun, LI Cheng-xin. Develop-ment of Particle Interface Bonding in Thermal Spray Coa-tings: A Review[J]. Journal of Thermal Spray Technology,2013, 22(2): 192-206.
[39]OHMORI A, LI Chang-jiu. Quantitative Characterization of the Structure of Plasma-Sprayed Al2O3 Coating by Using Copper Electroplating[J]. Thin Solid Films, 1991,201(2): 241-252.
[40]徐滨士, 李长久, 刘世参, 等. 表面工程与热喷涂技术及其发展[J]. 中国表面工程, 1998, 11(1): 3-9.
XU Bin-shi, LI Chang-jiu, LIU Shi-can, et al. Surface Engineering and Thermal Spraying Technology and Their Developments[J]. China Surface Engineerign, 1998,
11(1): 3-9.
[41]YAO Shu-wei, LI Chang-jiu, TIAN Jia-jia, et al. Condi-tions and Mechanisms for the Bonding of a Molten Ceramic Droplet to a Substrate after High-Speed Im-
pact[J]. Acta Materialia, 2016, 119: 9-25.
[42]AL-KUHAILI M F. Co-Sputtered Tantalum-Doped TinOxide Thin Films for Transparent Conducting Applica-tions[J]. Materials Chemistry and Physics, 2021, 257:
123749.
[43]LOCKER L D, MALM D L. Fabrication of Sputtering Sources by Plasma Spraying: Tantalum-Hafnium Mix-tures[J]. Review of Scientific Instruments, 1971, 42(11):
1696-1698.
[44]原慷, 彭浩然, 张鑫, 等. 一种高纯钽旋转靶材及其制备方法: 中国, 113308671A[P]. 2021-08-27.
YUAN Kang, PENG Hao-ran, ZHANG Xin, et al. High-Purity Tantalum Rotating Target Material and Preparation Method Thereof: China, 113308671A[P]. 2021-08-27.
[45]RANE G K, REN Wen-jing, SEIFERT M, et al. Studies on the Electrical Resistivity of Bilayer and Multilayer Thin Films of Sputtered Tungsten and Molybdenum[J].
Materials Science and Engineering: B, 2019, 243: 96-107.
[46]王跃明, 闵小兵, 熊翔, 等. 高品质钼靶材低压等离子喷涂成形技术研究[J]. 粉末冶金技术, 2017, 35(4):284-292.
WANG Yue-ming, MIN Xiao-bing, XIONG Xiang, et al.Study on the High-Quality Molybdenum Target Fabri-cated by Low Pressure Plasma Spraying[J]. Powder
Metallurgy Technology, 2017, 35(4): 284-292.
[47]谢康德. 难熔金属钨、钼管材的应用及其制备技术研究进展[J]. 硬质合金, 2018, 35(3): 219-225.
XIE Kang-de. Research Progress in Application and Preparation Technology of Refractory Metal Tungsten and Molybdenum Tubes[J]. Cemented Carbide, 2018, 35(3):219-225.
[48]WANG Yue-ming, TANG Qiu-hao, CHEN De-qiang,et al. Microstructure and Magnetron Sputtering Properties of Tungsten Target Fabricated by Low Pressure PlasmaSpraying[J]. International Journal of Refractory Metals and Hard Materials, 2020, 87: 105116.
[49]刚爽, 杨晔, 朱永明. 高致密度的硅铝旋转靶材的制备方法: 中国, 108707870A[P]. 2018-10-26.
GANG Shuang, YANG Ye, ZHU Yong-ming. Preparation Method of High-Compactness Aluminum-Silicon Rotary Target Material: China, 108707870A[P]. 2018-10-26.
[50]陈钦忠, 张科, 林志河. 一种旋转硅镁合金靶材及其制备方法: 中国, 105506564A[P]. 2018-08-17.
CHEN Qin-zhong, ZHANG Ke, LIN Zhi-he. Rotating Silicon-Magnesium Alloy Target and Preparation Method Thereof: China, 105506564A[P]. 2018-08-17.
[51]石煜, 曾墩风, 王志强, 等. 一种硅铬旋转溅射靶材及其制备方法: 中国, 113897585B[P]. 2022-06-17.
SHI Yu, ZENG Dun-feng, WANG Zhi-qiang, et al. Silicon-Chromium Rotary Sputtering Target Material and Prepa-ration Method Thereof: China, 113897585B[P]. 2022-06-17.
[52]DAUGHTRY J, ALOTABI A S, HOWARD-FABRETTO L, et al. Composition and Properties of RF-Sputter Deposited Titanium Dioxide Thin Films[J]. Nanoscale
Advances, 2021, 3(4): 1077-1086.
[53]TACHIBANA Y, OHSAKI H, HAYASHI A, et al. TiO2–xSputter for High Rate Deposition of TiO2[J]. Vacuum,2000, 59(2/3): 836-843.
[54]陈佳. 等离子喷涂 Nb2O5 溅射靶材的研究[D]. 天津:河北工业大学, 2016: 25-52.
CHEN Jia. Study on Plasma Spraying Nb2O5 Sputtering Target[D].Tianjin: Hebei University of Technology, 2016:25-52.
[55]TULUI M, BELLUCCI A, ALBOLINO A, et al. Zinc Oxide Targets for Magnetron Sputtering PVD Prepared by Plasma Spray[J]. Surface and Coatings Technology, 2010,205(4): 1070-1073.
[56]陈洁, 张忻, 刘洪亮, 等. 七铝酸十二钙电子化合物研究进展[J]. 材料导报, 2020, 34(13): 13076-13083.
CHEN Jie, ZHANG Xin, LIU Hong-liang, et al. Advances in the Study of C12A7: E- Electride[J]. Materials Reports,2020, 34(13): 13076-13083.
[57]杨永添, 张扬, 吴健, 等. 一种致密七铝酸十二钙陶瓷旋转靶材的制备方法: 中国, 112941477A[P]. 2021-06-11.
YANG Yong-tian, ZHANG Yang, WU Jian, et al. Pre-paration Method of Compact Dodecacalcium Heptaalu-minate Ceramic Rotating Target Material: China,
112941477A[P]. 2021-06-11.
[58]张玉玲, 甘志俭. ZMO 靶材及其制备方法: 中国,113073302A[P]. 2023-02-14.
ZHANG Yu-ling, GAN Zhi-jian. ZMO Target Materialand Preparation Method Thereof: China, 113073302A[P].2023-02-14.
[59]林志河, 陈钦忠, 汪家兵, 等. 一种三氧化二铝-TiOx 靶材及其制备方法和应用: 中国, 110257790B[P]. 2020-07-03.
LIN Zhi-he, CHEN Qin-zhong, WANG Jia-bing, et al.Preparation Method and Application of an Al2O3-TiOxTarget: China, 110257790B[P]. 2020-07-03.
[60]HUNG K Y, LAI Hong-chen, YANG Y C, et al. Chara-cterization of Hydroxyapatite (HA) Sputtering Targets by APS Methods[J]. Coatings, 2017, 7(11): 197.
[61]VAN DRIESSCHE I, GEORGIOPOULOS E, DENUL J,et al. Comparison of Plasma Sprayed and Flame Sprayed YBa2Cu3O7–x Targets for Rotatable Magnetron Sput-
tering[J]. Physica C: Superconductivity, 2002, 376: 1221-1224.
[62]YANG Wen-hao, TANG Bin, BAO Ming-dong, et al. Sur-face Morphology and Sputtering Mechanism of Etched Areas of a Metallic Target by Magnetron Sputtering[J].Journal of Electronic Materials, 2021, 50(4): 2409-2416.
[63]王瑜, 李艳丽, 夏峰, 等. 一种重稀土金属靶材修复方法: 中国, 110373642B[P]. 2021-08-10.
WANG Yu, LI Yan-li, XIA Feng, et al. Heavy Rare Earth Metal Target Material Repairing Method: China,110373642B[P]. 2021-08-10.
[64]张久兴, 高思远, 赵晶晶, 等. 一种 W 靶材的修复方法: 中国, 108817405B[P]. 2020-12-29.
ZHANG Jiu-xing, GAO Si-yuan, ZHAO Jing-jing, et al.Repairing Method of W Target Material: China,108817405B[P]. 2020-12-29.
[65]HUANG Lei, PAN Ya-fei, ZHANG Jiu-xing, et al. Fast In-Situ Repair Technology-a Novel SPS Process for the Waste Refractory W-10Ti Targets[J]. Vacuum, 2021, 192:110406.
[66]刘志强. 等离子喷涂 NiAl、NiCrAl 涂层去除工艺及再涂覆性能[D]. 哈尔滨: 哈尔滨工业大学, 2018: 42-52.
LIU Zhi-qiang. Removal Process and Recoating Perfor-mance of Plasma Sprayed NiAl and NiCrAl Coatings[D].Harbin: Harbin Institute of Technology, 2018: 42-52.
[67]林志河, 陈钦忠, 叶开满. 一种旋转铌残靶的修复方法: 中国, 110777320A[P]. 2020-02-11.
LIN Zhi-he, CHEN Qin-zhong, YE Kai-man. Repairing Method of Rotary Niobium Residual Target: China,110777320A[P]. 2020-02-11.
[68]葛源, 郑春园, 戴凌杰, 等. 旋转硅铝靶材再制造的装置及其制备方法: 中国, 113073297B[P]. 2023-05-02.
GE Yuan, ZHENG Chun-yuan, DAI Ling-jie, et al. Rotary Silicon-Aluminum Target Remanufacturing Device and Preparation Method Thereof: China, 113073297B[P].
2023-05-02.
相关链接